關鍵詞 |
碳化硅肖特基二極管 |
面向地區 |
金屬與 N 型 4H-SiC 半導體體內含有大量的導電載流子。金屬與 4H-SiC 半導體材料的接觸僅有原子大小的數量級間距時,4H-SiC 半導體的費米能級大于金屬的費米能級。此時 N 型 4H-SiC 半導體內部的電子濃度大于金屬內部的電子濃度,兩者接觸后,導電載流子會從 N 型 4H-SiC 半導體遷移到金屬內部,從而使 4H-SiC 帶正電荷,而金屬帶負電荷。電子從 4H-SiC 向金屬遷移,在金屬與 4H-SiC 半導體的界面處形成空間電荷區和自建電場,并且耗盡區只落在 N 型 4H-SiC 半導體一側,在此范圍內的電阻較大,一般稱作“阻擋層”。自建電場方向由 N 型 4H-SiC 內部指向金屬,因為熱電子發射引起的自建場增大,導致載流子的擴散運動與反向的漂移運動達到一個靜態平衡,在金屬與4H-SiC 交界面處形成一個表面勢壘,稱作肖特基勢壘。4H-SiC 肖特基二極管就是依據這種原理制成的。
產生二次擊穿的原因主要是半導體材料的晶格缺陷和管內結面不均勻等引起的。二次擊穿的產生過程是:半導體結面上一些薄弱點電流密度的增加,導致這些薄弱點上的溫度增加引起這些薄弱點上的電流密度越來越大,溫度也越來越高,如此惡性循環引起過熱點半導體材料的晶體熔化。此時在兩電極之間形成較低阻的電流通道,電流密度驟增,導致肖特基二極管還未達到擊穿電壓值就已經損壞。因此二次擊穿是不可逆的,是破壞性的。流經二極管的平均電流并未達到二次擊穿的擊穿電壓值,但是功率二極管還是會產生二次擊穿。
碳化硅作為一種寬禁帶半導體材料,比傳統的硅基器件具有更的性能。碳化硅的寬禁帶(3.26eV)、高臨界場(3×106V/cm)和高導熱系數(49W/mK)使功率半導體器件效率更高,運行速度更快,能夠有效降低產品成本、體積及重量。
碳化硅具有載流子飽和速度高和熱導率大的特點,應用開關頻率可達到1MHz,在高頻應用中優勢明顯,其中碳化硅肖特基二極管(SiC JBS)耐壓可以達到6000V以上。相對應的,硅材料的禁帶寬度較低,在較低的溫度下硅器件本征載流子濃度較高,而高的漏電流會造成熱擊穿,這限制了器件在高溫環境和大功率耗散條件下工作。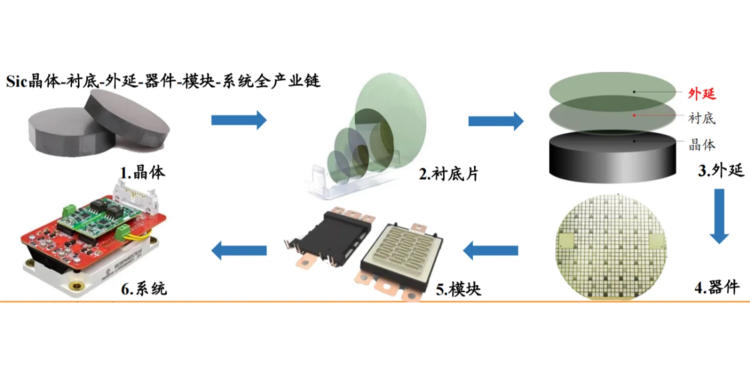
碳化硅(SiC)是一種的半導體材料,基于SiC的肖特基二極管(SiC Schottky Diode)具有更高能效、更高功率密度、更小尺寸和更高的可靠性,可以在電力電子技術領域打破硅的極限,成為新能源及電力電子的器件。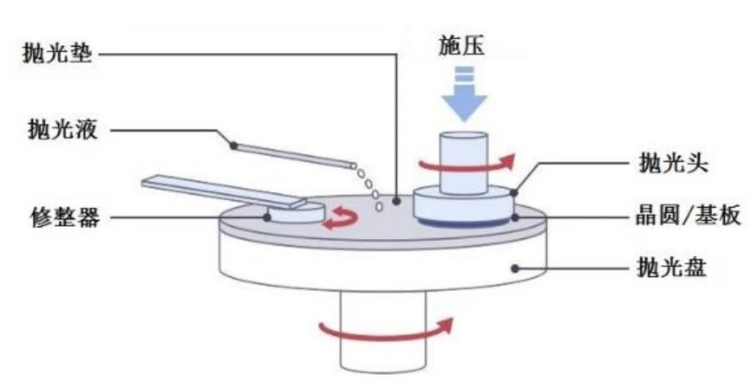
碳化硅肖特基二極管可廣泛應用于開關電源、功率因素校正(PFC)電路、不間斷電源(UPS)、光伏逆變器等中高功率領域,可顯著的減少電路的損耗,提高電路的工作頻率。在PFC電路中用碳化硅SBD取代原來的硅FRD,可使電路工作在300kHz以上,效率基本保持不變,而相比下使用硅FRD的電路在100kHz以上的效率急劇下降。隨著工作頻率的提高,電感等無源原件的體積相應下降,整個電路板的體積下降30%以上。